반도체 제조업 - 코스텍시스 -

코스텍시스는 고 방열 신소재 기술과 정밀 세라믹 패키지 기술을 기반으로 5G등 통신용 파워 트랜지스터(Power Transistor)의 세라믹 패키지(Ceramic Package)와 LCP(Liquid Crystal Polymer)패키지 및 QFN(Quad Flat No lead)패키지,세라믹 기판과 전기 자동차의 파워 반도체용 인터포저(Interporser),스페이서(Spacer)등 방열 부품을 제조 판매하는 사업을 영위하고 있습니다.
주력 제품인 5G등 통신용 파워 트랜지스터(Power Transistor)의 세라믹 패키지(Ceramic Package)와 LCP(Liquid Crystal Polymer)패키지 및 QFN(Quad Flat No lead)패키지를 글로벌 업체인 NXP사에 양산 납품하고 있으며, 미국,일본,중국,대만등 다수의 국내외 업체에 제품 판매가 증가되고 있습니다.
또한 전기 자동차의 파워 반도체용 인터포저(Interporser),스페이서(Spacer)등 방열 부품은 전기 자동차용 파워 반도체를 양산 계획중인 국내 H사,L사 등에 소량 제품을 지속적으로 판매하고 있으며 향후 수요 업체의 양산 시기에 따라 판매량의 큰폭 변화가 예상되고 있습니다
| 목적 사업 |
| 1. 반도체 부품 제조업 2. 광원 응용 기계 기구 및 부품 제조업 3. 광소재 부품 제조업 4. 반도체 장비 제조업 5. 수출입업 및 동 대행업 6. 도금업 7. 부동산업 및 부동산 임대업 8. 위 각호에 부대하는 사업 일체 |
주요 연혁
| 연월 | 내역 |
| 1997. 01 | 법인설립 |
| 2018.04 | 기업 부설 연구소 설립,ISO 9001 인증 취득 |
| 2018.06 | 정보 통신부 2002년 유망 중소 정보 통신 기업 선정(RF부품) |
| 2018.07 | 자가 공장 매입 이전 : 대지 451평 건물 485평 |
| 2018.08 | 산업 자원부 "부품 소재 기술 개발 사업" 수행 업체로 선정 |
| 2018.10 | K-OTC(한국금융투자협회) 등록 |
| 2018.11 | 산업 자원부 "부품 소재 기술 개발 사업" 주관 기관 선정 |
| 2019.01 | 지경부 고방열 신소재 및 파워 디바이스 패키지 개발 주관 기관 선정 |
| 2019.03 | 고방열 신소재 SCMC,CPC 개발 |
| 2019.06 | NXP사 RF 고주파 패키지 양산 납품 시작 |
| 2019.07 | 제 55회 무역의 날 수출 5백만불 탑 수상 |
| 2019.07 | 소재.부품 전문 기업 (제19981호)-산업 통상 자원부 |
| 2019.08 | ISO 14001/ ISO 45001/ IATF 16949 인증 취득 |
| 2019.12 | 벤처기업(벤처투자기업)재인증(제20190301230호) |
| 2020.01 | 뿌리기업 확인 인증 |
| 2020.01 | 글로벌 강소기업 지정(중소벤처기업부) |
| 2020.02 | "EV/HEV 전기 자동차 전력 반도체의 냉각 시스템을 위한 방열 소재 부품 개발" 주관기관 선정(중소벤처기업부) |
| 2020.02 | 5G mmWave 전력 증폭기용 다층 금속과 폴리머 융합의 Metal Guide Coaxial Type QFN(Quad Flat No Lead) 패키지 개발 주관기관 선정 |
| 2020.03 | 본사(공장)확장 (토지3,294.4㎡. 건물 3,700.78㎡) 매입(인천 남동구 논현동428-4) |
주요 주주현황 (기준일 : 2022년 6월 30일)
◆ 최대주주 및 특수관계인의 주식소유 현황
(단위 : 주, %)
| 성명 | 관계 | 주식의 종류 |
소유주식수 및 지분율 | 비고 (주요경력) |
|||
| 기초 | 기말 | ||||||
| 주식수 | 지분율 | 주식수 | 지분율 | ||||
| 한규진 | 대표이사 | 보통주 | 2,064,145 | 48,84 | 2,064,145 | 47.34 | 최근 5년간 (주)코스텍시스 대표이사 역임/기타겸임없음 |
| 우선주 | - | - | - | - | |||
| 김복순 | 특수관계인 | 보통주 | 244,751 | 54.63 | 244,751 | 5.61 | |
| 계 | 보통주 | 2,308,893 | 54.63 | 2,308,896 | 52.95 | ||
| 우선주 | - | - | - | - | |||
| 합 계 | 2,308,896 | 54.63 | 2,308,896 | 52.95 | |||
◆ 5%이상 주주의 주식소유 세부현황
(단위 : 주, %)
| 성명 | 보통주 | 소계 | ||
| 주식수 | 지분율 | 주식수 | 지분율 | |
| 한규진 | 2,064,145 | 47.34 | 2,064,145 | 47.34 |
| UI유망서비스벤처투자조합 | 600,000 | 13.76 | 600,000 | 13.76 |
| 오픈워터 Pre-IPO 투자조합13호 | 401,999 | 9.22 | 401,999 | 9.22 |
| 김복순 | 244,751 | 5.61 | 244,751 | 5.61 |
| 합 계 | 3,310,895 | 75.93 | 3,310,895 | 75.93 |
◆ 소액주주현황
(단위 : 주, %)
| 구 분 | 주주 | 보유주식 | ||
| 주주수 | 비율 | 주식수 | 비율 | |
| 소액주주 | 93 | 95.87 | 1,049,544 | 24.06 |
주요 사업
코스텍시스는 고 방열 신소재 기술과 정밀 세라믹 패키지 기술을 기반으로 5G등 통신용 파워 트랜지스터(Power Transistor)의 세라믹 패키지(Ceramic Package)와 LCP(Liquid Crystal Polymer)패키지 및 QFN(Quad Flat No lead)패키지,세라믹 기판과 전기 자동차의 파워 반도체용 인터포저(Interporser),스페이서(Spacer)등 방열 부품을 제조 판매하는 사업을 영위하고 있습니다.
코스텍시스는 1997년 일본,유럽등 선진기업에서 전량 수입하여 사용하고 있는 고 방열 신소재를 방열 기판으로 사용하고 있는 파워 반도체용 패키지의 국산화 개발 공급 및 세계 시장 진출을 목표로 설립되었으며, 고 방열 신소재의 지속적인 개발과 고 방열 패키지 공급을 통하여 회사의 고유기술과 아이템을 확립하고 글로벌 시장에서 기업 브랜드 가치를 높여가고 있습니다.
회사 설립 초기에는 반도체 부품인 K-Ring & Lid, Laser Diode용 Cu-Stem, 고주파 패키지등을 개발 생산하여 일본 Kyocera,Murata,중국 Hosonic,대만 Siward등 해외 다수의 업체에 제품 승인을 획득하는등 독자적으로 시장을 개척하여 수출위주로 사업을 영위하여 왔으며 반도체 패키지분야와 고방열 신소재 분야의 연구 개발에 주력하며 기술을 축적하였습니다.
회사의 중장기 발전과 시장성에 주목하여 고 방열 신소재와 전력증폭기/파워 트랜지스터용 세라믹 패키지의 국산화 개발을 시작하였습니다. 무선 통신의 GaN Device는 High Power,High Frequence,고집적화에 따라 방열성능이 우수한 방열소재 필요성이 크게 대두되고 있어서 높은 열전도율과 금속이 가지는 열팽창율을 조합하여 고방열 복합소재이면서 열팽창 계수가 반도체 소자에 가까운 복합소재를 기술을 확보 하였고 이를 기반으로 최적의 RF 파워디바이스용 패키지를 개발하였으며 파워디바이스 패키지 및 그 제조방법에 관련한 27건의 특허와 5G 통신 등 고출력 RF 디바이스의 성능과 직결되는 방열 핵심 기술을 보유하게 되었고 여기에 후막 세라믹 기술(Thick Film Ceramic),확산접합(Diffusion Bonding)기술, 고진공 브레이징 기술, 고순도 도금 기술, 초정밀 고속 펀칭 등의 파워디바이스용 세라믹 패키지 분야의 기술을 축적하여 기술적 기반을 마련하였습니다.
글로벌 기술명가인 NXP의 품질관리 기준은 유독 까다로운 것으로도 정평이 나있있는데, 3년에 걸친 까다로운 승인과정을 통과하고 우수한 생산 품질 시스템을 구축하여 NXP 부품 납품업체로 선정되었습니다.
국내에서 유일하게 고방열 신소재(sCMC)를 개발하여 소재 생산부터 고방열 RF패키지까지 일괄 생산 시스템을 구축하여 글로벌 경쟁력을 갖추게 되었으며, 일본기업이 오랜기간 독점해오고 있었던 세계 최대 수요처인 NXP사의 3년에 걸친 까다로운 승인과정을 거처 납품업체로 2016년 9월 정식 등록을 하고 거래가 시작 되었습니다
NXP사의 5G통신용 GaN 디바이스용 고방열 세라믹 패키지등 다양한 모델 수주와 더블어 신규 매출처 다변화를 위해 일본,미국등 글로벌 고객사를 대상으로 활발히 영업 활동을 진행하여 국내 및 해외 다수의 기업으로부터 수주가 지속적으로 증가하고 있습니다.
또한 고방열 신소재(sCMC)부터 고방열 패키지까지 일괄 생산 시스템을 구축으로 원가등 글로벌 경쟁력은 한층 강화되고 있어서, 5G 무선통신용 세라믹 패키지,Polymer 패키지,QFN 패키지 및 전기 자동차의 파워 반도체용 고 방열 신소재 부품등 주력 제품의 해외수출이 큰 폭으로 증가하고 있습니다.
주요 제품 및 서비스
◆ 전력 증폭기 / 파워 트랜지스터
전력 증폭기/파워 트랜지스터는 무선통신기술에서 원하는 위치에서 원하는 신호를 송수신하기 위해서는 기후,지형,건물 등 외부 영향에 의해 신호가 변형,왜곡이 발생하지 않도록 무선통신장비의 송수신단에서 신호를 증폭시켜 주는 중요한 역할을 담당하고 있습니다.
이러한 전력 증폭기/파워 트랜지스터 기술은 무선통신장비의 성능을 결정하는 핵심 요소로서 5G 상용화와 함께 마크로 셀(Macro Cell),스몰 셀(Small Cell),대용량 다중 입출력 장치(Massive MIMO),FEM(Front End Module),MMIC(Monothic Microwave Itegrated Circuit)등 활용 범위가 크게 넓어지고 제품이 다양해지고 있습니다.
◆ 전력 증폭기/파워 트랜지스터용 반도체 패키징(Packaging)
반도체 패키징 기술이란 반도체를 외부단자와 칩을 연결하고 칩에서 발생하는 열을 외부로 방출하며 충격이나 습기로부터 보호하여 전자 디바이스의 성능과 신뢰성을 확보하는 기술입니다.
반도체 패키징이 필요한 이유는 전기적인 연결이라는 관점에서 볼 때, 반도체 칩과 전자제품 메인보드의 회로 폭에 차이가 있기 때문이며 전자 제품을 동작시키는 역할의 반도체칩은 그 자체로는 역할을 할 수 없기 때문에 전자 제품을 구성하는 회로에 연결되어야 비로소 반도체 칩의 기능을 수행할 수 있습니다.
전력 증폭기 및 파워 트랜지스터의 패키징은 매우 높은 정밀도와 수율이 요구되고 있으며 우주 항공 및 방위 산업을 근간으로 이제는 5G 무선 통신, 무선 LAN (Local Area Network), 위성 통신 및 자동차 전자 기기등으로 광범위하게 확대되고 있습니다.
◆ 고방열 신소재, 부품
고방열 소재 및 부품은 반도체 모듈의 가동 중 발생하는 열을 제어하여 제품의 수명과 성능을 결정하는 반도체 소자 핵심 요소 기술로 국가중점투자전략 산업분야인 5G, HEV, IoT, AI, 디스플레이 등 전 산업분야에 사용되고 있습니다.
반도체 모듈의 불량은 습도, 먼지, 진동 및 온도에 의해 발생되는데 특히 온도에 의한 고장이 55% 이상 차지하며, 소자 작동 온도가 10℃ 상승할 때 모듈의 수명은 2배 감소합니다. 최근 반도체 기술이 급속하게 발전하여 반도체 기판소재가 기존 Si, GaAs에서 GaN, SiC 소재로 변경되어 모듈에 High Frequency, High voltage가 인가됨에 따라 발생하는 열을 외부로 전달하는 방열기능 향상에 대한 중요도가 증가하고 있으며, 반도체 모듈의 작동온도가 증가함에 따라 칩, 기판, 베이스플레이트 재료 등의 서로 다른 사용재료 사이의 열팽창 계수 차이(CTE mismatch)가 발생하고, 모듈의 반복적인 승온과 냉각으로 패키지에 열응력이 누적되어 Die attach 불량, 기판과 베이스 플레이트 사이의 박리(delamination) 등의 신뢰성 불량현상 등이 발생하고 있어 고열적특성(고 열전도 도, 저 열팽창 계수)의 방열 부품 소재가 요구되고 있습니다.
일본등 해외 선진사에서는 반도체 모듈의 방열 효율을 높이기 위하여 고방열 신소재 개발 및 제조에 대한 연구가 광범위하게 이루어지고 있으며 시스템 반도체,전력 반도체등 다양한 산업에 응용되고 있습니다.
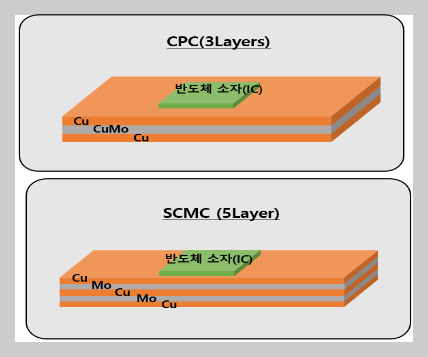
- SCMC(Super-CMC) : Cu(구리)와 Mo(몰리브덴)의 다층 적층 구조로 열팽창 계수가 낮으면서도 열 전도율이 우수한 고방열 신소재입니다.
- CPC : Cu(구리)와 CuMo(동 몰리브덴)의 적층 구조로 열팽창 계수가 낮으면서도 열 전도율이 우수한 고방열 신소재입니다.
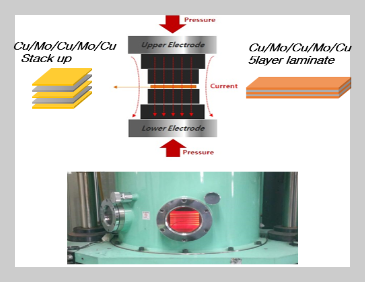
- Spark Plasma Sintering(통전 활성 소결) 기술로 Copper와 Molybdenum을 확산 접합하여 접합 계면에 Void가 없고 방열 특성이 우수합니다.
- Cu-Mo의 구성,적층 비율을 조정하여 반도체 소자와 방열특성,열팽창 계수 매칭등 Thermal Solution을 제공합니다.



통신, 자동차, 국방,우주항공,의료,에너지등 반도체의 패키지용 방열기판을 생산,공급하고 있습니다.
- Materials : Cu,CuW,CuMo,CPC,CMC,sCMC etc.
- process : Stamping,CNC Machinig etc.
- Plating : Nickel electroplating,Nickel electrolessplating,NiCo,Au,Pd,Cu etc.
원재료 및 생산설비
◆ 주요 원재료 매입 현황
(단위 : 백만원)
| 매입유형 | 품 목 | 구 분 | 2022년도 (제26기) 반기 |
2021년도 (제25기) |
2020년도 (제24기) |
| 원재료 | PGC 및 기타 | T사 등 | 9,016 | 5,664 | 3,915 |
◆ 원재료 가격변동 추이
(단위 : 천원/Gram)
| 품 목 | 2022년도 (제26기) 반기 |
2021년도 (제25기) |
2020년도 (제24기) |
| PGC | 49 | 46 | 46 |
◆ 생산능력 및 생산실적
(단위 : 개)
| 제품 품목명 | 구분 | 2022년도 (제26기) 반기 |
2021년도 (제25기) |
2020년도 (제24기) |
| 통신용 부품 (RF PKG) |
생산능력 | 8,000,000 | 6,000,000 | 5,000,000 |
| 생산실적 | 3,949,437 | 2,441,808 | 1,922,877 | |
| 가동율 | 49% | 40% | 38% |
주) 제품군에 속하는 품목들의 특성등이 다품목이기 때문에 대표모델을 기준으로 작성함.
◆ 생산설비 현황
(단위 : 천원)
| 공장별 | 자산별 | 소재지 | 기초가액 | 당기증감 | 당기상각 | 재평가 | 기말가액 | |
| 증가 | 감소 | |||||||
| 공장 | 토지 | 1. 인천광역시 남동구 능허대로 625번길 43 2. 인천광역시 남동구 남동서로 261 |
14,342,284 | - | - | 14,342,284 | ||
| 건물 | 2,749,539 | - | (15,691) | 2,733,848 | ||||
| 기계장치 | 831,424 | - | (24,156) | 807,268 | ||||
| 공구와기구 | 94,654 | - | (9,813) | 84,841 | ||||
| 시설장치 | 119,516 | - | (13,950) | 105,566 | ||||
| 합계 | 18,137,417 | - | (63,610) | 18,073,807 | ||||
매출 현황
◆ 매출 실적
(단위: 백만원)
| 사업부문 | 매출유형 | 품 목 | 제26기 반기 | 제25기 | 제24기 | |
| 통신부품 | 제품 | PKG | 수 출 | 13,716 | 9,136 | 6,866 |
| 내 수 | 1,446 | 1,222 | 861 | |||
| 합 계 | 15,162 | 10,358 | 7,727 | |||
| 합 계 | 수 출 | 13,716 | 9,136 | 6,866 | ||
| 내 수 | 1,446 | 1,222 | 861 | |||
| 합 계 | 15,162 | 10,358 | 7,727 | |||
◆ 주요 매출처 및 전략
반도체 패키지의 소재 부품 분야는 고방열 소재 기술이 뒷받침되지 못하면 제품 경쟁력이 약화될 수 밖에 없습니다. 신기술 적용, 소재 개발 및 생산 능력, 안정적 제품 공급을 위해서는 고방열 반도체 디바이스 사업자들과 연구단계에서부터 상호 협력적인 파트너십이 구축되어야 합니다. 따라서 효율적이고 효과적인 영업 전략을 위해서는 시장분석 및 선행 연구, 제품 경쟁력, 고객 대응력, 경영 실적 등 다양한 요소들이 결합되어야만 합니다.
코스텍시스는 고방열 소재 기술을 기반으로 고방열 반도체 패키지의 소재 부품 분야에 탁월한 글로벌 경쟁력을 보유하고 있으며, 주요 고객들인 화합물 반도체 업체,전력 반도체 업체들의 요구사항을 사전에 판단하고 준비함으로써 경쟁력을 확보하고 있습니다.
주요 계약 및 연구개발활동
◆ 연구개발비용
(단위 :천원)
| 과목 | 제26기 반기 | 제25기 | 제24기 | |
| 원 재 료 비 | 21,656 | 50,354 | 213,521 | |
| 인 건 비 | 251,508 | 308,448 | 393,150 | |
| 감 가 상 각 비 | ||||
| 위 탁 용 역 비 | ||||
| 기 타 | 25,475 | 72,706 | 73,418 | |
| 연구개발비용 계 | 298,639 | 431,508 | 680,089 | |
| 회계처리 | 판매비와 관리비 | 273,462 | 381,154 | 507,269 |
| 제 조 경 비 | ||||
| 개발비(무형자산) | 25,177 | 50,354 | 172,820 | |
| 연구개발비 / 매출액 비율 [연구개발비용계÷당기매출액×100] |
1.96% | 4.16% | 8.80% | |
◆ 연구개발 실적
| 주요 개발 내용 | 개발기간 | 지원기관 | 비고 |
| 블루투스의 세라믹 다층 팩키지(통합모듈)를 제조하기 위한 세라믹 적층 성형장비 개발 | 01.04.-02.03. | 중소기업청 | 성공 |
| Saw Filters의 핵심부품인 Kovar 3*3 개발 | 01.05.-02.04. | 정보통신부 | 성공 |
| MU형 집적화 Ferrule의 정밀 성형기술 개발 | 02.08.-03.07. | 산업자원부 | 성공 |
| Saw Filters의 초소박형화를 위한 복합 소재의 "Clad Lid"개발 | 02.11.-04.10. | 산업자원부 | 성공 |
| 세라믹 팩키지 봉지용 에폭시수지 CAP 개발 | 03.08.-04.07. | 중소기업청 | 성공 |
| Multi Cavity Lid 및 공정기술개발 | 04.12.-05.11. | 정보통신부 | 성공 |
| 열방출성능이 탁월한 조명용 LED Package 개발 | 05.07.-06.06. | 중소기업청 | 성공 |
| 이종재 복합성형기술을 이용한 고출력 LD용 "STEM" 개발 | 06.06.-08.07. | 산업자원부 | 성공 |
| 초소형 프로젝터 광원용 LD패키지 개발 | 08.08.-10.07. | 중소기업청 | 성공 |
| LD용 Eutectic Bonding Type Open Package 개발 | 09.06.-11.05. | 지식경제부 | 성공 |
| Power Device용 RF Package 개발 | 10.09.-11.12. | 지식경제부 | 성공 |
| GaN,SiC 파워 디바이스용 열전도율 500W/m.K급 Al-Dia.복합 소재의 방열 패키지 개발 | 12.11.~14.10 | 지식경제부 | 성공 |
| Micro Channel 개발 | 13.05.~15.05 | 지식경제부 | 성공 |
| 전력반도체용 IGBT 기판개발 | 14.01.~16.06 | 지식경제부 | 성공 |
| LiDAR부품 Laser Diode용 Clad소재 및 패키지 개발 | 19.06~20.06 | 중소벤처부 | 성공 |
| 5G 통신을 위한 3.7GHz 300W급 고출력 GaN 파워 트랜지스터 기술 및 전력증폭기 개발 | 20.04~22.12 | 정보통신부 | 수행중 |
| EV/HEV전력 반도체의 냉각 시스템을 위한 방열소재 및 부품개발 | 20.06~22.06 | 중소벤처부 | 수행중 |
| 5G mmWave 전력 증폭기용 다층 금속과 폴리머 융합의 Metal Guide Coaxial Type QFN(Quad Flat No Lead) 패키지 개발 | 21.07~22.22 | 산업자원부 | 수행중 |
회사개요
◆ 스팩개요
| 회사명 | [코스닥] 교보10호기업인수목적 주식회사 | 회사영문명 | Kyobo 10 Special Purpose Acquisition Company |
| 설립일 | 2020. 04. 28. | 국적 | 대한민국 |
| 대표이사 | 박상연 | 대표전화 | 02-3771-9125 |
| 종업원수 | 57 명 | 홈페이지 | |
| 업종 | 기타 금융업 | 기업구분 | 일반 |
| 본점소재지 | 서울특별시 영등포구 의사당대로 97 교보증권 빌딩 17층 | ||
| 결산월 | 12 월 | 주당액면가 | 500 원 |
◆ 스팩개요
| 심사청구일 | 2022. 08. 31. | 심사결과 | - |
| 스팩합병대상법인 | [코스닥] 코스텍시스 | 회사영문명 | KOSTECSYS Co.,Ltd. |
| 설립일 | 1997. 01. 08 | 국적 | 대한민국 |
| 대표이사 | 한규진 | 대표전화 | |
| 종업원수 | 57 명 | 홈페이지 | https://www.kostec.net/ |
| 업종 | 반도체 제조업 | 기업구분 | 이노비즈&벤처 |
| 본점소재지 | 인천광역시 남동구 능허대로625번길 43 | ||
| 결산월 | 12 월 | 주당액면가 | 500 원 |
| 최대주주 | 한규진 | 최대주주 지분율 | 47 % |
| 상장주선인 | 교보증권 | 감사인 | 삼덕회계법인 |
심사결과

IPO준비를 진행 중이거나 신규 상장한 기업을 이해하기 위한 목적이며, 투자 권유를 목적으로 하지 않습니다.
투자에 관한 결정은 투자자 본인에게 있으며 그 책임 또한 본인에게 있습니다.
'주식투자 > 2022년 IPO' 카테고리의 다른 글
| [2022년 IPO 예비심사기업] 진영(JINYOUNG CO., LTD) (0) | 2022.11.22 |
|---|---|
| [2022년 IPO 예비심사기업] 산돌(Sandoll, Inc.) (0) | 2022.11.21 |
| [2022년 IPO 예비심사기업] 엑스게이트(AXGATE Co., Ltd.) (2) | 2022.11.20 |
| [2022년 IPO 예비심사기업] 팸텍(PAMTEK Co., Ltd.) (0) | 2022.11.17 |
| [2022년 IPO 예비심사기업] 이노시뮬레이션(INNOSIMULATION CO., LTD.) (2) | 2022.11.16 |